芯片封装工艺
引言
提起芯片,大家应该都不陌生。芯片,作为集成电路(Integrated Circuit,IC)的载体,是一项世界各国都在大力发展研究的高科技产业。IC产业主要由IC设计业、IC制造业及IC封测业三个部分组成。在本文中,我们将带大家认识一下IC封测业中的芯片封装技术。
02何谓芯片封装
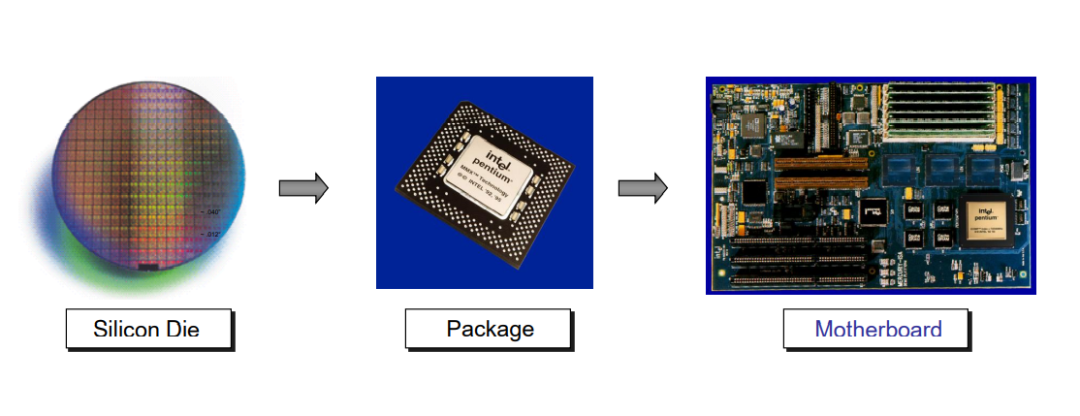
图1芯片封装的定位(图片来源老师课件)
生活中说起封装,可能就是把东西放进箱子,然后用胶带封口,箱子起到的最大作用也就是储存,将箱子里面与箱子外面分隔开来。但在芯片封装中,“箱子”可有着更大的作用。安装集成电路芯片用的外壳,它不仅起着安放、固定、密封、保护芯片和增强导热性能的作用,而且还是沟通芯片内部世界与外部电路的桥梁——芯片上的接点用导线连接到封装外壳的引脚上,这些引脚又通过印刷电路板上的导线与其他器件建立连接。
从由硅晶圆制作出来的各级芯片开始,芯片的封装可以分为三个层次,即用封装外壳将芯片封装成单芯片组件(Single Chip Module,简称SCM)和多芯片组件(MCM)的一级封装,也称为片级封装;将一级封装和其他元器件一同组装到印刷电路板(PWB)(或其它基板)上的二级封装,也称为板级封装;以及再将二级封装插装到母板上的三级封装,也称为系统级封装。
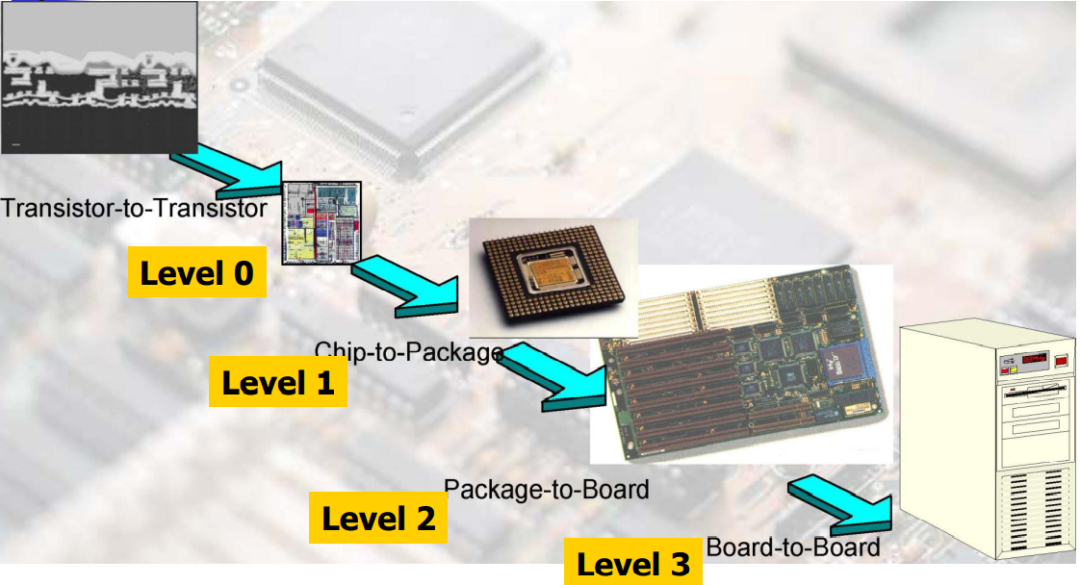
图2芯片封装分级(图片来源老师课件)
其实,在一、二、三级封装与IC芯片之间还有一个步骤,被称为芯片互连级封装,其主要作用就是通过互连技术将IC芯片焊区与各级封装的焊区连接起来,也就是让芯片能够通过外壳与外界产生交流,零级封装也被称为芯片互连级。
03芯片封装的功能

表1芯片封装的五大功能
04芯片封装的几种技术
4.1芯片互连技术
芯片互连技术来自与我们上文提到的零级封装,这是芯片与封装外壳以及外界环境建立联系的关键技术。芯片互连技术主要有三种:引线键合、载带自动焊以及倒装焊。
(a) 引线键合
 图3引线键合示意图
图3引线键合示意图
(b) 载带自动焊
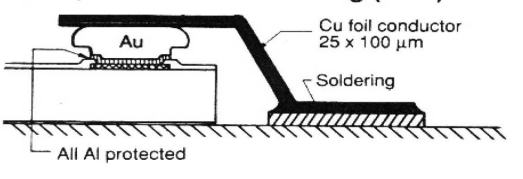 图 4 载带自动焊示意图
图 4 载带自动焊示意图
(c) 倒装焊
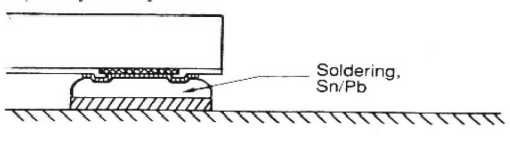 图 5 倒装焊示意图
图 5 倒装焊示意图

表2三种芯片互连技术对比
4.2 BGA封装技术
 图6
BGA封装
图6
BGA封装
BGA(Ball Grid Array):球栅阵列。它是在基板的下边按面阵方式引出球形引脚,在基板上面贴装大规模集成电路芯片,是大规模集成电路芯片常用的一种表面贴装型封装形式。
优点:BGA封装的封装尺可以做的更小,同时也更节省PCB板的布线面积。
缺点:电路板的弯曲应力导致潜在的可靠性问题,BGA封装更容易受到压力
4.3 CSP封装技术
CSP(Chip Size Package),即芯片尺寸封装。是指封装尺寸不超过裸芯片1.2倍的一种先进的封装形式(美国JEDEC标准)。CSP技术是在对现有的芯片封装技术,其是对成熟的BGA封装技术做进一步技术提升的过程中,不断将各种封装尺寸进一步小型化而产生的一种封装技术。
优点:体积小;可容纳引脚数多;电性能良好;散热性能好
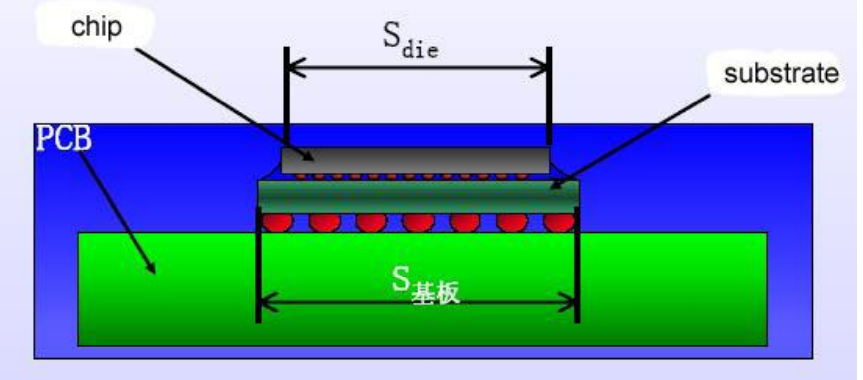
图7 CSP结构示意图(图片来源网络)
05未来封装技术的展望
现在,IC产业中芯片的封装与测试已经与IC设计和IC制造一起成为了密不可分又相对独立的三大产业,往往设计制造出的同一块芯片却要采用各种不同的封装形式与结构,在未来芯片封装又将如何发展呢?在这一部分将为大家介绍未来封装产业的发展趋势以及几种先进的可能占据未来市场的封装技术。
5.1未来封装技术的几大趋势
(1) 由有封装向少封装和无封装发展
(2) 无源器件走向集成化
(3)3D封装技术
5.2晶圆级封装(WLP)技术
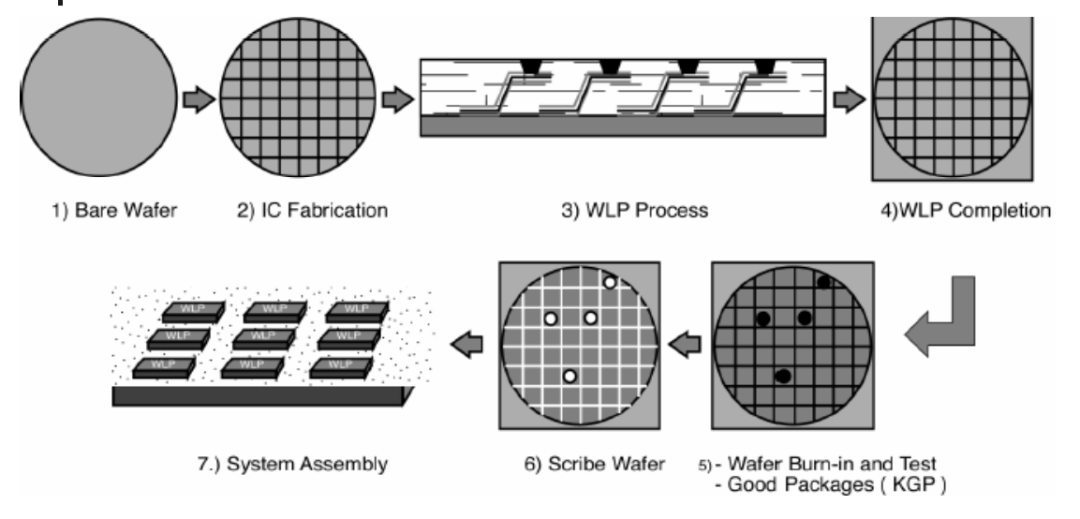
图8 WLP技术流程(图片来源老师课件)
WLP是Wafer Level Packaging的缩写。晶圆级封装,就是在硅片上依照类似半导体前段的工艺,通过薄膜、光刻、电镀、干湿法蚀刻等工艺来完成封装和测试,最后进行切割,制造出单个封装成品。
优势:封装工艺简化以及封装尺寸小。
5.3 SOC & SIP
SOC(System on Chip),即片上系统,指的是将实现系统功能的各个模块集成到一个芯片上。这意味着在单个芯片上,就能完成一个电子系统的功能。
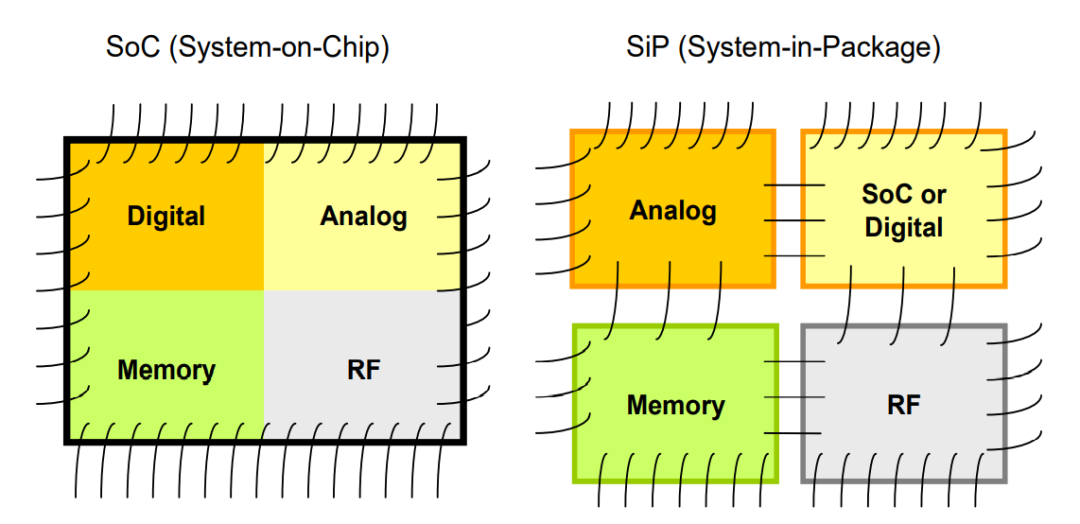
图9 SOC与SIP对比示意图(图片来源网络)
SIP是System in a Packaging的缩写,指的是将几个实现不同模块功能的芯片放到一个封装中去。
5.4 SOP

图10 SOP的地位(图片自制)
SoP是System-on-package的缩写,是被提出来作为整合系统的概念,希望将数字、模拟、射频、微机电、光学电路或次系统都整合在封装上,除了提高系统整合程度外,同时亦保有可接受的成本效益。SOP的另一个优点是与SOC及SIP兼容,SOC与SIP均可视为SOP的次系统,一起被整合在封装上。


.png)

